双象股份,光刻胶的重要上游,别只盯光刻胶/机
光刻胶树脂是半导体光刻胶核心原材料,国内90%以上依赖进口分享:发布时间:2022-12-19 来源:立鼎产业研究网 点击量: 3340 光刻胶树脂是光刻胶核心组成部分,直接决定光刻胶在特定波长下可以达到的线宽,在原材料成本占比约50%,不同光刻胶树脂的结构不同:用于I线(365nm)和G线(436nm)的光刻胶主要成分是聚合物树脂、光敏化合物(PAC)和溶剂。溶剂含量变化可以改变光刻胶粘度,从而在合理的转速范围内得到刻蚀所需的厚度;PAC是重氮萘醌酯化合物,主要用于线性酚醛树脂体系光刻胶中,如g线/i线光刻胶,决定光刻胶的光敏程度,在光子的作用下,PAC分解,进而激发光化学反应。目前绝大多数的I/G线胶都是以酚醛树脂和二氮醌(DNQ)为主要成分的“novolac/DNQ”胶,其中DNQ占总质量的20%-50%。I/G线胶单体、酚醛树脂和DNQ 来源:CNKI248nm以下光刻胶则使用以聚合物树脂、光致酸产生剂(PAG)、相应添加剂及溶剂为主要成分的化学放大胶。由于酚醛树脂对250nm以下的光有较强的吸收率且只能激发一次的光化学反应也难以满足高精度电路的光敏需求,因此248nm及以下的光刻胶不再使用酚醛树脂类单体,而是采用化学放大光刻法。化学放大胶的工作原理为:1)光子被PAG吸收,PAG分解并释放H+;2)烘烤时,酸与树脂上的不容性悬挂基团反应,使聚合物能溶液显影液,同时能释放一个新的H+。通过化学放大法,使得光刻胶对光照非常敏感,很少量的光刻胶就能够完成整个区域的曝光,无论是从技术层面还是经济效益来说都有其优势,因此也被广泛KrF(248nm)光刻胶、ArF(193nm)光刻胶和ArF(193nm)浸没式光刻胶。PBOCST化学放大发原理
来源:CNKI248nm以下光刻胶则使用以聚合物树脂、光致酸产生剂(PAG)、相应添加剂及溶剂为主要成分的化学放大胶。由于酚醛树脂对250nm以下的光有较强的吸收率且只能激发一次的光化学反应也难以满足高精度电路的光敏需求,因此248nm及以下的光刻胶不再使用酚醛树脂类单体,而是采用化学放大光刻法。化学放大胶的工作原理为:1)光子被PAG吸收,PAG分解并释放H+;2)烘烤时,酸与树脂上的不容性悬挂基团反应,使聚合物能溶液显影液,同时能释放一个新的H+。通过化学放大法,使得光刻胶对光照非常敏感,很少量的光刻胶就能够完成整个区域的曝光,无论是从技术层面还是经济效益来说都有其优势,因此也被广泛KrF(248nm)光刻胶、ArF(193nm)光刻胶和ArF(193nm)浸没式光刻胶。PBOCST化学放大发原理 来源:CNKI常用于KrF(248nm)的光刻胶是有IBM最早研发的tBOC胶,所使用的聚合物树脂为PBOSCT。根据化学放大原理,受到光照后,光致酸产生剂释放H+,在后续PEB过程中酸导致悬挂基团脱落并生成一个新亲水酸分子。PBOSCT光敏感度比novolac/DNQ胶提升两个数量级,且具备正/负胶选择能力,因此被广泛应用于130-180nm分辨率的光刻工艺。ArF光刻胶以PMMA为树脂式材料,浸没式ArF胶进一步增加隔水涂层等改进性能。由于芳香结构的PBOCST对193nm光吸收较强,因此ArF胶多采用基本对193nm光透明无吸收的聚甲基丙烯酸甲酯PMMA为树脂材料。而用于浸没式ArF光刻胶在此基础上又进行多次改进,如引入隔水涂层来减少H2O对光刻工艺的影响,采用大分子疏水性PAG降低酸(H+)向水体系的扩散等,采用多重曝光技术最高可满足7nm节点需求。极紫外EUV光刻可实现线宽减小,对光刻胶材料要求更苛刻,目前以金属基光刻胶为主流。EUV波长13.5nm,仅为ArF胶的不到1/10,因此可实现的关键线宽大幅缩小。当前EUV光刻胶主要包括聚合物基光刻胶、有机分子玻璃光刻胶、金属基光刻胶等,其中金属基光刻胶由于具有尺寸小、EUV吸收率高等显著优势,研究进度较快。光刻特征尺寸与光源波长的发展(R为分辨率,k 为工艺参数)
来源:CNKI常用于KrF(248nm)的光刻胶是有IBM最早研发的tBOC胶,所使用的聚合物树脂为PBOSCT。根据化学放大原理,受到光照后,光致酸产生剂释放H+,在后续PEB过程中酸导致悬挂基团脱落并生成一个新亲水酸分子。PBOSCT光敏感度比novolac/DNQ胶提升两个数量级,且具备正/负胶选择能力,因此被广泛应用于130-180nm分辨率的光刻工艺。ArF光刻胶以PMMA为树脂式材料,浸没式ArF胶进一步增加隔水涂层等改进性能。由于芳香结构的PBOCST对193nm光吸收较强,因此ArF胶多采用基本对193nm光透明无吸收的聚甲基丙烯酸甲酯PMMA为树脂材料。而用于浸没式ArF光刻胶在此基础上又进行多次改进,如引入隔水涂层来减少H2O对光刻工艺的影响,采用大分子疏水性PAG降低酸(H+)向水体系的扩散等,采用多重曝光技术最高可满足7nm节点需求。极紫外EUV光刻可实现线宽减小,对光刻胶材料要求更苛刻,目前以金属基光刻胶为主流。EUV波长13.5nm,仅为ArF胶的不到1/10,因此可实现的关键线宽大幅缩小。当前EUV光刻胶主要包括聚合物基光刻胶、有机分子玻璃光刻胶、金属基光刻胶等,其中金属基光刻胶由于具有尺寸小、EUV吸收率高等显著优势,研究进度较快。光刻特征尺寸与光源波长的发展(R为分辨率,k 为工艺参数) ArF光刻胶以PMMA为树脂式材料浸没式ArF胶进一步增加隔水涂层等改进性能。由于芳香结构的PBOCST对193nm光吸收较强,因此ArF胶多采用基本对193nm光透明无吸收的聚甲基丙烯酸甲酷PMMA为树脂材料。而用于浸没式ArF光刻胶在此基础上又进行多次改进,如引入隔水涂层来减少H20对光刻工艺的影响,采用大分子疏水性PAG降低酸(H+)向水体系的扩散等,采用多重曝光技术最高可满足7nm节点需求。
ArF光刻胶以PMMA为树脂式材料浸没式ArF胶进一步增加隔水涂层等改进性能。由于芳香结构的PBOCST对193nm光吸收较强,因此ArF胶多采用基本对193nm光透明无吸收的聚甲基丙烯酸甲酷PMMA为树脂材料。而用于浸没式ArF光刻胶在此基础上又进行多次改进,如引入隔水涂层来减少H20对光刻工艺的影响,采用大分子疏水性PAG降低酸(H+)向水体系的扩散等,采用多重曝光技术最高可满足7nm节点需求。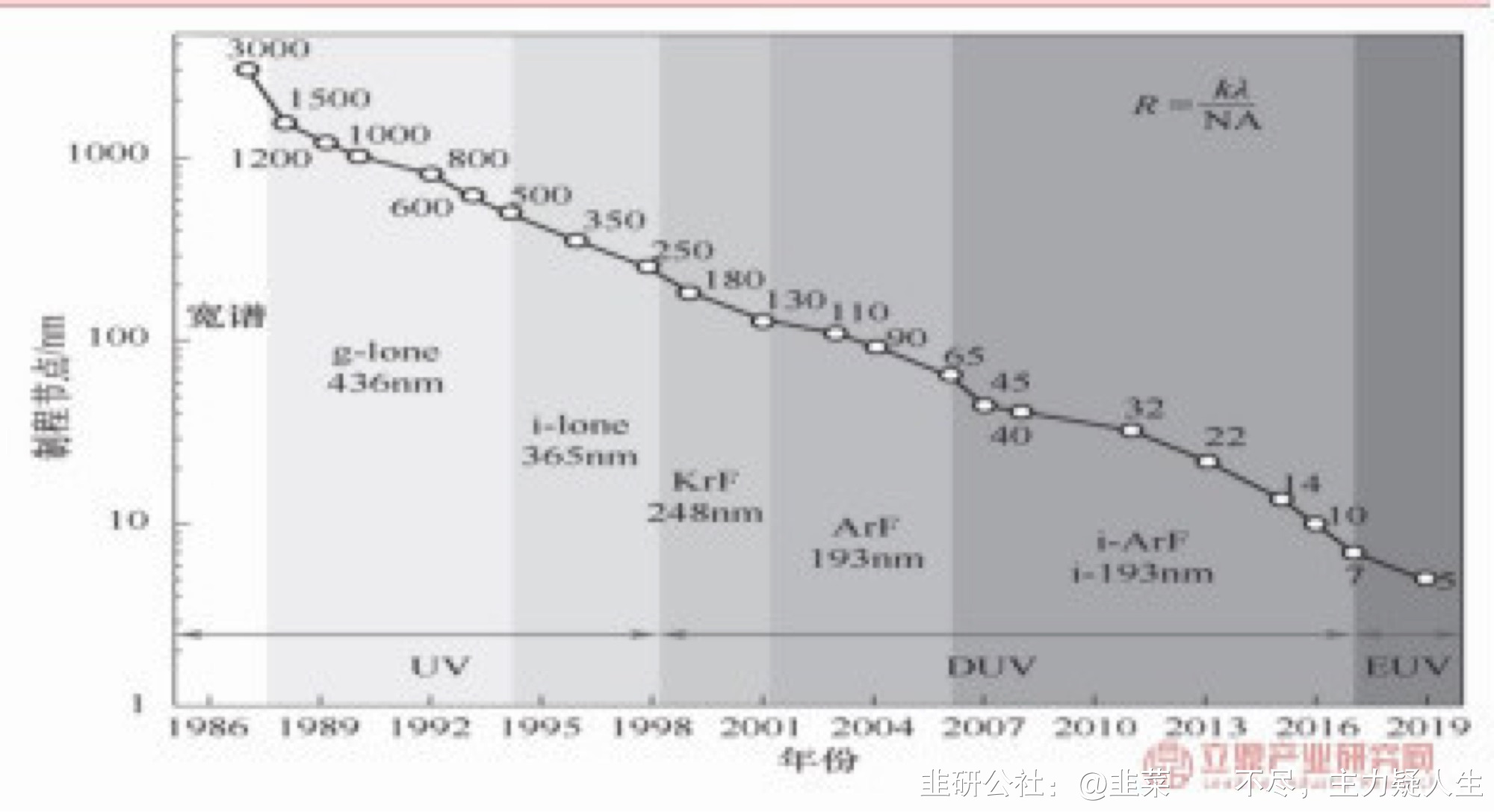 http://www.leadingir.com/trend/view/7048.html光刻胶树脂是半导体光刻胶核心原材料,国内90%以上依赖进口
http://www.leadingir.com/trend/view/7048.html光刻胶树脂是半导体光刻胶核心原材料,国内90%以上依赖进口
 来源:CNKI248nm以下光刻胶则使用以聚合物树脂、光致酸产生剂(PAG)、相应添加剂及溶剂为主要成分的化学放大胶。由于酚醛树脂对250nm以下的光有较强的吸收率且只能激发一次的光化学反应也难以满足高精度电路的光敏需求,因此248nm及以下的光刻胶不再使用酚醛树脂类单体,而是采用化学放大光刻法。化学放大胶的工作原理为:1)光子被PAG吸收,PAG分解并释放H+;2)烘烤时,酸与树脂上的不容性悬挂基团反应,使聚合物能溶液显影液,同时能释放一个新的H+。通过化学放大法,使得光刻胶对光照非常敏感,很少量的光刻胶就能够完成整个区域的曝光,无论是从技术层面还是经济效益来说都有其优势,因此也被广泛KrF(248nm)光刻胶、ArF(193nm)光刻胶和ArF(193nm)浸没式光刻胶。PBOCST化学放大发原理
来源:CNKI248nm以下光刻胶则使用以聚合物树脂、光致酸产生剂(PAG)、相应添加剂及溶剂为主要成分的化学放大胶。由于酚醛树脂对250nm以下的光有较强的吸收率且只能激发一次的光化学反应也难以满足高精度电路的光敏需求,因此248nm及以下的光刻胶不再使用酚醛树脂类单体,而是采用化学放大光刻法。化学放大胶的工作原理为:1)光子被PAG吸收,PAG分解并释放H+;2)烘烤时,酸与树脂上的不容性悬挂基团反应,使聚合物能溶液显影液,同时能释放一个新的H+。通过化学放大法,使得光刻胶对光照非常敏感,很少量的光刻胶就能够完成整个区域的曝光,无论是从技术层面还是经济效益来说都有其优势,因此也被广泛KrF(248nm)光刻胶、ArF(193nm)光刻胶和ArF(193nm)浸没式光刻胶。PBOCST化学放大发原理 来源:CNKI常用于KrF(248nm)的光刻胶是有IBM最早研发的tBOC胶,所使用的聚合物树脂为PBOSCT。根据化学放大原理,受到光照后,光致酸产生剂释放H+,在后续PEB过程中酸导致悬挂基团脱落并生成一个新亲水酸分子。PBOSCT光敏感度比novolac/DNQ胶提升两个数量级,且具备正/负胶选择能力,因此被广泛应用于130-180nm分辨率的光刻工艺。ArF光刻胶以PMMA为树脂式材料,浸没式ArF胶进一步增加隔水涂层等改进性能。由于芳香结构的PBOCST对193nm光吸收较强,因此ArF胶多采用基本对193nm光透明无吸收的聚甲基丙烯酸甲酯PMMA为树脂材料。而用于浸没式ArF光刻胶在此基础上又进行多次改进,如引入隔水涂层来减少H2O对光刻工艺的影响,采用大分子疏水性PAG降低酸(H+)向水体系的扩散等,采用多重曝光技术最高可满足7nm节点需求。极紫外EUV光刻可实现线宽减小,对光刻胶材料要求更苛刻,目前以金属基光刻胶为主流。EUV波长13.5nm,仅为ArF胶的不到1/10,因此可实现的关键线宽大幅缩小。当前EUV光刻胶主要包括聚合物基光刻胶、有机分子玻璃光刻胶、金属基光刻胶等,其中金属基光刻胶由于具有尺寸小、EUV吸收率高等显著优势,研究进度较快。光刻特征尺寸与光源波长的发展(R为分辨率,k 为工艺参数)
来源:CNKI常用于KrF(248nm)的光刻胶是有IBM最早研发的tBOC胶,所使用的聚合物树脂为PBOSCT。根据化学放大原理,受到光照后,光致酸产生剂释放H+,在后续PEB过程中酸导致悬挂基团脱落并生成一个新亲水酸分子。PBOSCT光敏感度比novolac/DNQ胶提升两个数量级,且具备正/负胶选择能力,因此被广泛应用于130-180nm分辨率的光刻工艺。ArF光刻胶以PMMA为树脂式材料,浸没式ArF胶进一步增加隔水涂层等改进性能。由于芳香结构的PBOCST对193nm光吸收较强,因此ArF胶多采用基本对193nm光透明无吸收的聚甲基丙烯酸甲酯PMMA为树脂材料。而用于浸没式ArF光刻胶在此基础上又进行多次改进,如引入隔水涂层来减少H2O对光刻工艺的影响,采用大分子疏水性PAG降低酸(H+)向水体系的扩散等,采用多重曝光技术最高可满足7nm节点需求。极紫外EUV光刻可实现线宽减小,对光刻胶材料要求更苛刻,目前以金属基光刻胶为主流。EUV波长13.5nm,仅为ArF胶的不到1/10,因此可实现的关键线宽大幅缩小。当前EUV光刻胶主要包括聚合物基光刻胶、有机分子玻璃光刻胶、金属基光刻胶等,其中金属基光刻胶由于具有尺寸小、EUV吸收率高等显著优势,研究进度较快。光刻特征尺寸与光源波长的发展(R为分辨率,k 为工艺参数) ArF光刻胶以PMMA为树脂式材料浸没式ArF胶进一步增加隔水涂层等改进性能。由于芳香结构的PBOCST对193nm光吸收较强,因此ArF胶多采用基本对193nm光透明无吸收的聚甲基丙烯酸甲酷PMMA为树脂材料。而用于浸没式ArF光刻胶在此基础上又进行多次改进,如引入隔水涂层来减少H20对光刻工艺的影响,采用大分子疏水性PAG降低酸(H+)向水体系的扩散等,采用多重曝光技术最高可满足7nm节点需求。
ArF光刻胶以PMMA为树脂式材料浸没式ArF胶进一步增加隔水涂层等改进性能。由于芳香结构的PBOCST对193nm光吸收较强,因此ArF胶多采用基本对193nm光透明无吸收的聚甲基丙烯酸甲酷PMMA为树脂材料。而用于浸没式ArF光刻胶在此基础上又进行多次改进,如引入隔水涂层来减少H20对光刻工艺的影响,采用大分子疏水性PAG降低酸(H+)向水体系的扩散等,采用多重曝光技术最高可满足7nm节点需求。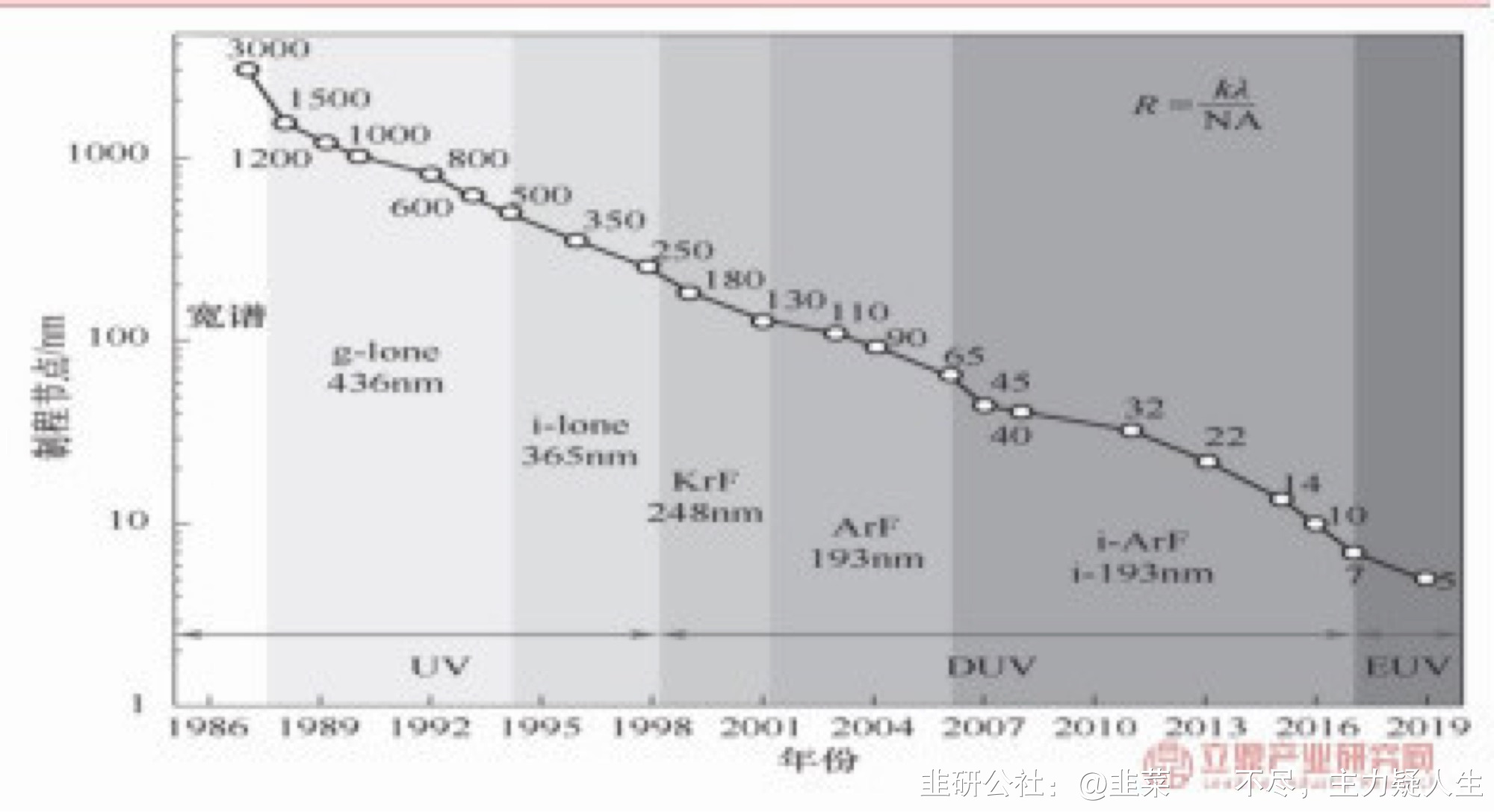 http://www.leadingir.com/trend/view/7048.html光刻胶树脂是半导体光刻胶核心原材料,国内90%以上依赖进口
http://www.leadingir.com/trend/view/7048.html光刻胶树脂是半导体光刻胶核心原材料,国内90%以上依赖进口
作者利益披露:转载,不作为证券推荐或投资建议,旨在提供更多信息,作者不保证其内容准确性。
声明:文章观点来自网友,仅为作者个人研究意见,不代表韭研公社观点及立场,站内所有文章均不构成投资建议,请投资者注意风险,独立审慎决策。
S
双象股份
工分

0.81
转发
收藏
投诉
复制链接
分享到微信

有用 3
打赏作者

无用
真知无价,用钱说话
0个人打赏
同时转发
评论(1)
只看楼主
热度排序
最新发布
最新互动
- 1








